热销产品
散热传导和热阻
为了在理论上尽可能提高芯片的载流能力,必须通过改善结合层和模块同冷却片的接触,使功耗最低。在导通,截止过程中的散热质量和开关的 热损耗Ptot,都可以通过芯片温度(Tj)和冷却片温度(Ts)的温差来表示。
热阻Rth(j-s)(静态)或者热抗Zth(j-s)(动态)的定义为:
以前为了表示截止层的温度还在字母下增加一个v 表示。但实际上只是一个测量值。对含有底板的模块,热阻或者热抗被分为外部部分(Rth(c-s) 和 Zth(c-s),底板和冷却板间)和内部部分(Rth(j-c) 和 Zth(j-c)芯片和底板间):
Rth(j-s) = Rth(j-c) + Rth(c-s)
Zth(j-s) = Zth(j-c) + Zth(c-s)
对没有底板模块就不太好分开测量,所以就定义一个总的阻抗。小功率元器件的结果同外部环境温度也有很大关联。图2.5.13 给出了一个带底板模块的等效图,这时的热阻是:
(d :材料强度,λ:热传导率,A:电流穿过的面积)
一些模块内部的参数会对热传导和Rth(j-s) 及 Zth(j-s)有影响:- 芯片参数(面积,厚度,布局和放置)
- DCB 基板的构造(材料,厚度,基板表面结构)
- 连接芯片和基板的材料和质量(焊接,粘结等)
- 是否有底板(材料,形状)
- 基板和底板的焊接(材料,质量)
- 模块的安装(表面质量/同冷却片的连接效果,导热膏或导热膜的厚度和质
量)
通过联合使用热容量公式:
Cth = s · V
以及热等效模型,可以按几何形状计算出每层的热量,(s = 储热系数,V = 体积)。在计算面积和体积时,应考虑到热传导,在复杂的电源模块中,每层会相互加温(热耦合)。大部分理论上计算的热阻会低于实际的测量值。原因是除了散热的不确定性和相互热耦合性外,边界层会有干扰出现。这在等效模型中没有被考虑。所以这种等效模型对复杂的电子功率系统是不准确的。通常情况下,通过对计算值Rth 进行加权处理来得出同实际测量值相近的Rth 值。
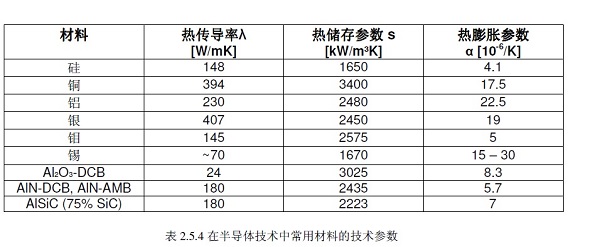
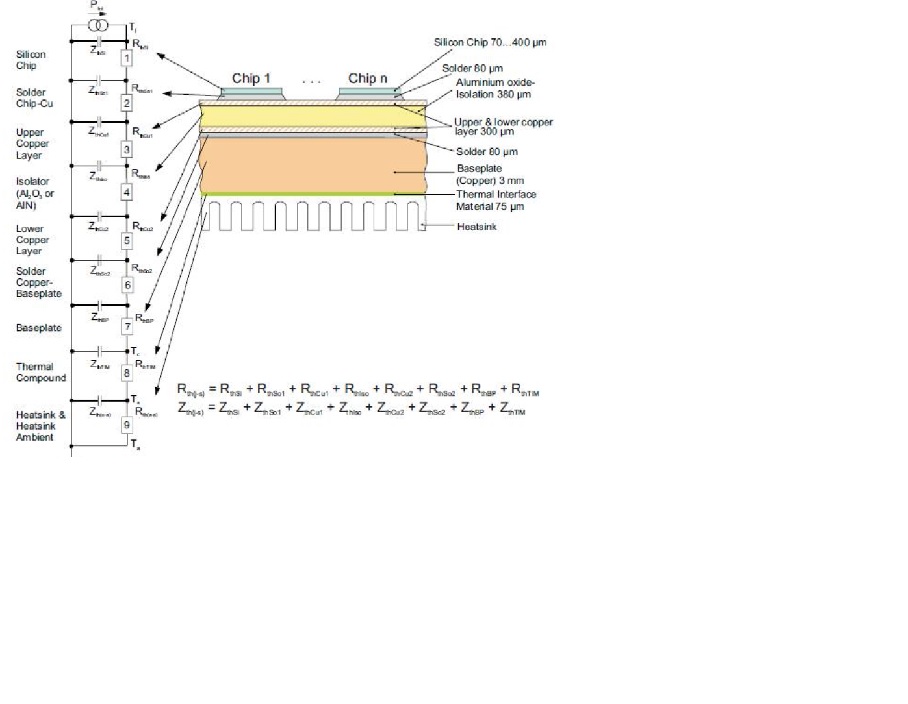
Rth(j-s)再加上散热条件和环境条件决定了模块的最大允许功率损耗。电力半导体模块的发展方向就是减少层数,减少厚度(0.63 毫米→0.38 毫米陶瓷),以及使用热传导性能更好的材料(氮化铝,石墨)。这种发展使电压绝缘性和机械强度几乎接近材料的物理极限值。
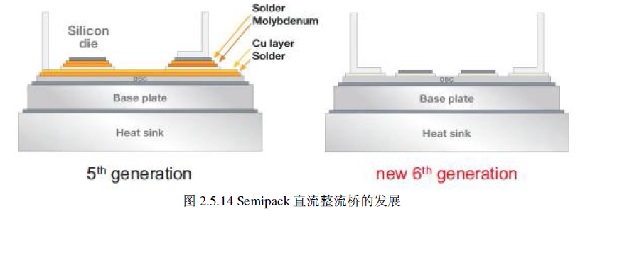
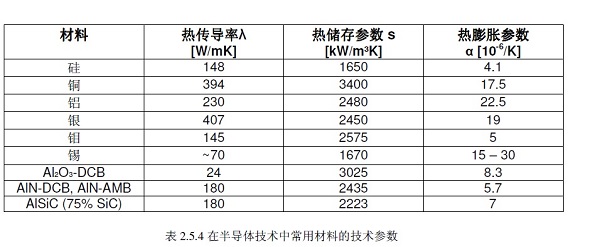
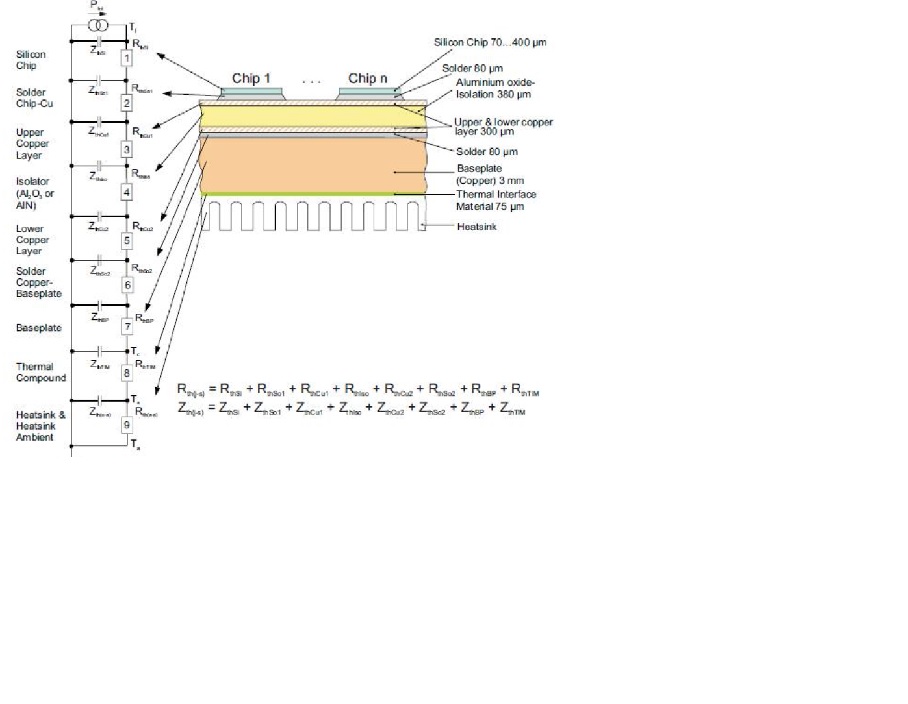
Rth(j-s)再加上散热条件和环境条件决定了模块的最大允许功率损耗。电力半导体模块的发展方向就是减少层数,减少厚度(0.63 毫米→0.38 毫米陶瓷),以及使用热传导性能更好的材料(氮化铝,石墨)。这种发展使电压绝缘性和机械强度几乎接近材料的物理极限值。
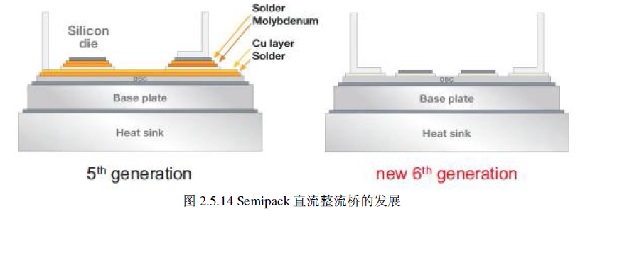
服务热线:021-58979561
业务咨询qq:447495955
业务咨询qq:1852433657
业务咨询qq:513845646
技术支持qq:313548578
技术交流群:376450741
业务咨询:
业务咨询:
业务咨询:
技术支持:
媒体合作:
沪ICP备09068927号 igbt8.com版权所有 Copyright 2008-2018
URL:http://www.igbt8.com qq:1852433657 欢迎加入IGBT技术交流群:376450741
技术支持: IGBT应用技术网
URL:http://www.igbt8.com qq:1852433657 欢迎加入IGBT技术交流群:376450741
技术支持: IGBT应用技术网