热销产品
热变化中的电路板连接
在这个试验中,是把组装和焊接好功率半导体模块的电路板放置到极端温度变化的环境中。焊接连接在实验周期的一半就开始出现脱焊,而可自由移动弹簧连接能通过整个2000 次温度循环的试验。循环温度是从-40 度到125 度。
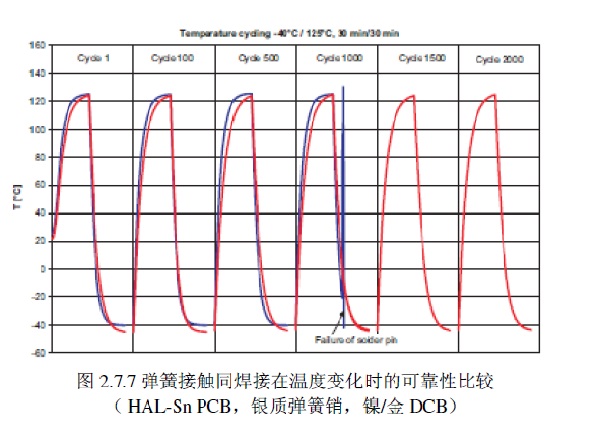
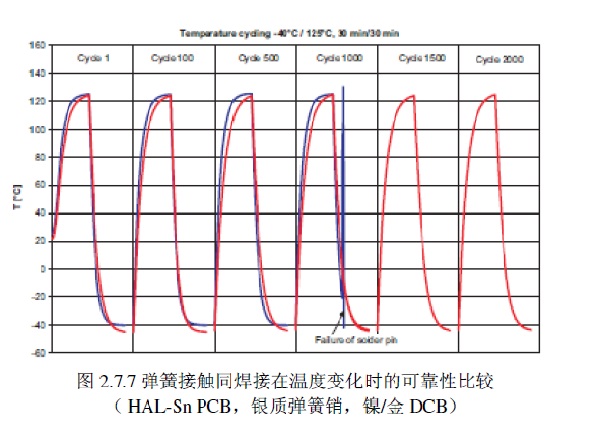
负荷变化时的失效机理
热膨胀系数不同的材料在温度时会产生连接老化,何时元器件彻底失效取决于负载和冷却条件。连接点离芯片的距离越远就受热越慢。半导体散热冷却的效果越差就会使越多的层温度升高。为了提高功率模块抗负载的可靠性,应该在尽量靠近错误的源头(最接近热源)的地方作出改善。温度的增加 T 会引起所有连接点膨胀最后导致脱焊。在九十年代开发出来的无底板模块就是减少了一个容易出错的焊接连接层。芯片连接使用烧结技术,明显的提高了失效的界限,但底板连接仍然是这个连接链中最薄弱的环节。底板连接技术在最近几年得到改进,现在已能够使寿命周期达到10 到15年。图2.7.8 显示了IGBT 模块的结构图。 其中红色是影响模块寿命的连接。
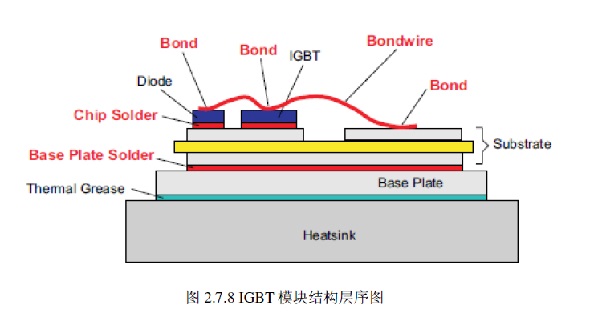
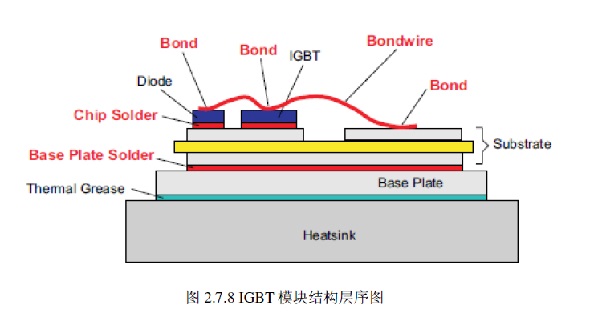
从图2.7.9 和图2.7.8 可以看出,最关键的环节是铜底板同基板的焊接,因为它们两层材料的膨胀系数的差异和是在模块中最大的连接面积。因此,在这里必须使用非常高质量的钎料和钎焊工艺技术,这样可以保证在大的温度变化时,连接层不会变形和脱落。此外,还经常使用分成小块的DCB 板来取代整个大板,这样可以减小中间部位产生的热膨胀应力,从而提高连接的可靠性。另一个发展方向是用小的膨胀系数材料(如AlSiC)取代铜作为底板材料或者彻底放弃底板。图片2.7.9 给出了边长1 厘米的不同层次理论上的热线性膨胀。从图上看出它们的差异。长度大表明带来高的热应力。左边是一个典型的实际应用的条件TC = 80°C 和Tj = 125°C 。模块中的温度梯度导致了铜底板热膨胀度只有芯片的两倍多,尽管它的热膨胀系数是芯片的四倍。右边是被动被加热时的情况,如通过汽车冷却水带来的不同热膨胀系数材料的不同膨胀延伸。该表还显示了氮化铝(AIN)陶瓷更为适应硅材料,但增加了氮化铝陶瓷与铜质底板之间的热机械应力,使这种组合很少或者在一定的限制条件下被使用。从使用寿命的角度去看,一个更好的结合是氮化铝陶瓷同AlSiC底板的结合。氧化铝陶瓷的热膨胀介于硅和铜之间,因此也就构成了理想的中间层。底板的导线不是大面积的连接,它的热膨胀表现在导线的弯曲度。同样,因为材料的热膨胀系数的差别,硅芯片同铝质导线也会产生应力。

服务热线:021-58979561
业务咨询qq:447495955
业务咨询qq:1852433657
业务咨询qq:513845646
技术支持qq:313548578
技术交流群:376450741
业务咨询:
业务咨询:
业务咨询:
技术支持:
媒体合作:
沪ICP备09068927号 igbt8.com版权所有 Copyright 2008-2018
URL:http://www.igbt8.com qq:1852433657 欢迎加入IGBT技术交流群:376450741
技术支持: IGBT应用技术网
URL:http://www.igbt8.com qq:1852433657 欢迎加入IGBT技术交流群:376450741
技术支持: IGBT应用技术网