热销产品
底板的焊接疲劳
底板的焊接疲劳
模块底板大面积的焊接疲劳是一个速度较慢的过程和在较强的热应力中才发生的。首先,从一个角落开始焊锡撕裂,这就增加了热阻,从而导致芯片温度上升,这也会加速热应力,直至烧毁芯片。所以底板的焊接必须经过温度变化试验。
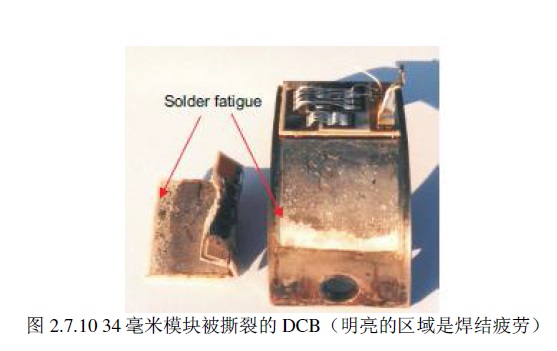
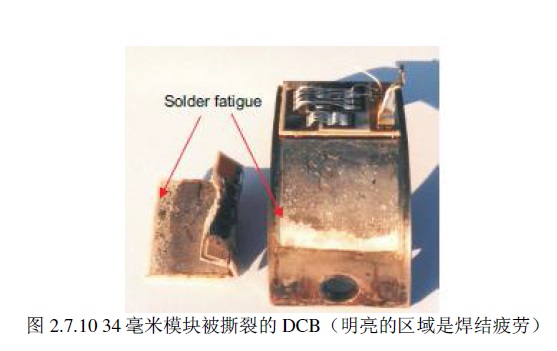
很明显,只要芯片能够通过基板到冷却器的散热足够好,我们就能通过取消底板来减少一个造成损坏的环节。这项技术在SKiiP,SKiM, MiniSKiiP 和 SEMITOP 模块中被使用。
芯片的焊接疲劳
芯片焊料疲劳通常同连线损坏同时发生。整个模块发热越多,就会导致越多的焊点疲劳。焊点疲劳是导致热阻Rth 和芯片温度的增加,从而导致IGBT 更高的损失,同时也会产生更高的温度差 T,最后加速了老化进程。
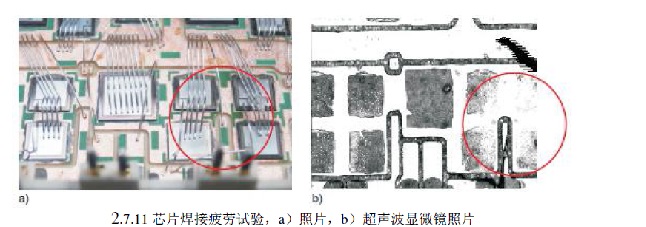
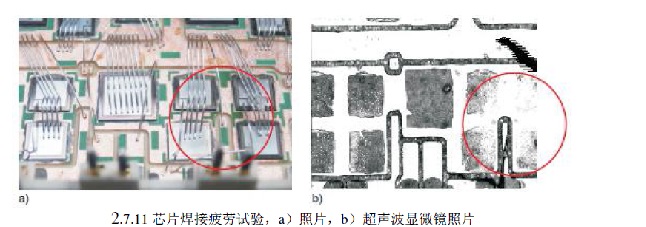
在DCB 板上右边四个IGBT 芯片上(图2.7.11)有变化负载,而其他的IGBT 和CAL二极管芯片没有变化负荷。在超声波显微镜下可以观测到这个负载造成的剥离分层。一个电流流过这4 个平行的芯片,芯片的中心点是温度最高点。它可以清楚地看出,分层是从内角开始的,当芯片面积较大,所以芯片的温度梯度也就较大,这时这种剥离分层不是从内角而是从温度变化 T 最大的中心点开始[文献47]。这种效应会对提高允许芯片温度(如提高到175 度)和温度变化 T 有重大的影响。连接芯片反面到基板的焊接,可以通过下面措施得以改善其耐温度变化:
- 选择膨胀系数比氧化铝(Al2O3)更接近硅的氮化铝(AIN)做衬底
- 用NTV 技术(低温接合技术)替代一般的焊接,通过烧结使银粉粘合芯片和基板,这个烧程需要较低温度和较高压力,这样可以减小在在烧结过程中连接材料之间的热应力。
服务热线:021-58979561
业务咨询qq:447495955
业务咨询qq:1852433657
业务咨询qq:513845646
技术支持qq:313548578
技术交流群:376450741
业务咨询:
业务咨询:
业务咨询:
技术支持:
媒体合作:
沪ICP备09068927号 igbt8.com版权所有 Copyright 2008-2018
URL:http://www.igbt8.com qq:1852433657 欢迎加入IGBT技术交流群:376450741
技术支持: IGBT应用技术网
URL:http://www.igbt8.com qq:1852433657 欢迎加入IGBT技术交流群:376450741
技术支持: IGBT应用技术网