热销产品
带电场阻止层和沟槽栅极结构的NPT-设计
当今使用最广的IGBT 芯片就是用NPT 型,但通过增加电场阻止层和采用垂直的沟槽设计来完善的(图2.4.10)。
它也是以很薄的、掺杂浓度很低的n-硅片作为基板,采用移植技术,在背面形成集电极p+区,在这层的上面额外移植一层n+电场阻止层。如同在PT 设计中,利用高掺杂浓度的n+半导体作为缓冲层来减少漂移区的厚度的原理一样,使电场在n+漂移区的边缘被消除。这层不能像PT-IGBT 中那样降低发射效率,而只能消除电场,所以它的掺杂浓度没有在PT-IGBT 那么高。
在同样的正向截止电流时,SPT-IGBT 漂流区的厚度wB 相对NPT-IGBT 来说要薄,所以通态压降就较小。同时它还保留其通态压降同温度的正比的特性和较高的坚固性。在关断时,同没有电场阻止层的IGBT 相对比,有阻止层的IGBT 拖尾电流开始时较高,但很快会下降。垂直的栅极沟槽设计是指栅极垂直的立在IGBT 内p 区的沟道内。因为增大了硅片的有效面积,所以更容易控制沟道的截面面积,并能实现更小的沟道电阻。在给定的硅片面积时,单元的面积可以做的更小,就能近一步使IGBT 实现承受更高的电流密度,更小的通态功耗,更好的抗锁定性,更小的整体功耗和承受更高的耐压。到目前为至,由Infineon 公司生产的最新一代的IGBT4 比它上一代的IGBT3 进一步减小了单元间距(相邻两个单元的基极间距),也就是芯片“收缩”了。通过芯片的优化和减小厚度,芯片的静态和动态特性都有所提高。较小的芯片也会带来较高的热敏电阻Rth(j-c) 和 Rth(j-s)。在提高元器件功率的同时,元器件可靠工作温度也得到提升,例如IGBT4 的可靠工作温度为175°C,而IGBT3 只有150°C。对于不同的要求可以调整到不同的静态和动态特性:
- IGBT4 T4: 在额定电流值从10A 到300A 时,模块有特别短的开关时间。
- IGBT4 E4: 在额定电流值从150A 到1000A 时,模块有特别小的导通损耗和开
关损耗。
- IGBT4 P4: 在额定电流值超过900A 时,大电流IGBT 模块有软恢复特性和特别
低的导通损耗。
赛米控公司(SEMIKRON)目前生产新一代IGBT4 芯片T4 和E4,来取代上一代IGBT3 的产品。
CSTBT设计
Mitsubishi 公司把在漂移区上部分建立空穴屏障同沟槽栅极结构结合,生产出存储势垒沟槽栅极双极晶体管(Carrier Stored Trench Gate Bipolar Transistor ,CSTBT)。如图2.4.13。它以前也被称为注入式增强栅极晶体管(Injection Enhaced Gated Transistors,IEGT)。这种IGBT 因为空穴屏障,原理如同在SPT+设计中所描述的,提高了在n 发射极的载流子注入率。这层n 掺杂的半导体层同沟槽结构一起,在p 半导体层下面。在屏蔽层的下方,聚集了带正电的载流子,它有效的促使从沟道输出电子,这样就使自由载子的浓度提高。
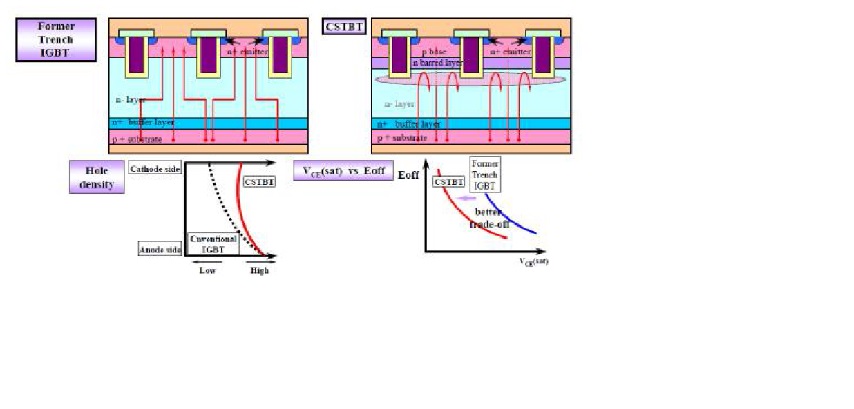
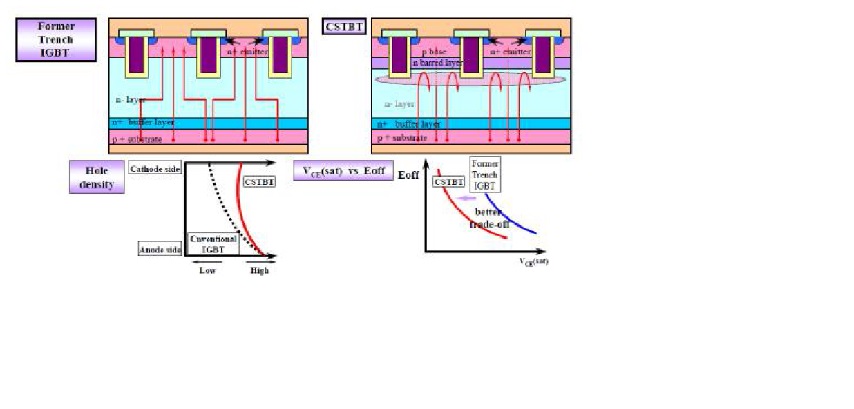
另外,Mitsubishi 公司还把CSTBT 同NPT 技术结合起来,通过外延生长技术,用廉价的薄硅片替代单晶材料。
插入单元(Plugged Cells)不是每个单元单独的被连接,而是用在栅极部位的多晶硅,经过发射极金属化被短路连接。(plugged cells:插入单元)。这样可使IGBT 的特性进一步改善。提高单元间的间距和减小p 区域大小,能使发射极的载流子浓度大幅度提高,它对通态压降产生很大影响,通过这些措施而升高的电压差降在沟道区域[文献22]。它带来的另一个好处是相对传统的IGBT 降低了短路时的集电极电流。
服务热线:021-58979561
业务咨询qq:447495955
业务咨询qq:1852433657
业务咨询qq:513845646
技术支持qq:313548578
技术交流群:376450741
业务咨询:
业务咨询:
业务咨询:
技术支持:
媒体合作:
沪ICP备09068927号 igbt8.com版权所有 Copyright 2008-2018
URL:http://www.igbt8.com qq:1852433657 欢迎加入IGBT技术交流群:376450741
技术支持: IGBT应用技术网
URL:http://www.igbt8.com qq:1852433657 欢迎加入IGBT技术交流群:376450741
技术支持: IGBT应用技术网